
KRI 射频离子源 RFICP 系列
上海伯东美国 KRI 射频离子源 RFICP 系列, 无需灯丝提供高能量, 低浓度的离子束, 通过栅极控制离子束的能量和方向, 单次工艺时间更长! 射频源 RFICP 系列提供完整的套装, 套装包含离子源本体, 电子供应器, 中和器, 自动控制器等. 射频离子源适合多层膜的制备, 离子溅镀镀膜和离子蚀刻, 有效改善靶材的致密性, 光透射, 均匀性, 附着力等.
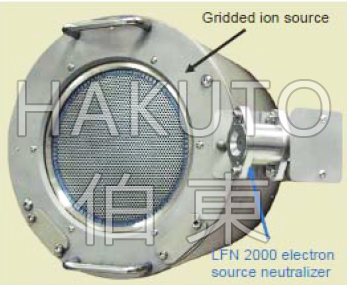
射频离子源 RFICP 系列技术参数:
|
型号 |
|||||
|
Discharge 阳极 |
RF 射频 |
RF 射频 |
RF 射频 |
RF 射频 |
RF 射频 |
|
离子束流 |
>100 mA |
>350 mA |
>600 mA |
>800 mA |
>1500 mA |
|
离子动能 |
100-1200 V |
100-1200 V |
100-1200 V |
100-1200 V |
100-1200 V |
|
栅极直径 |
4 cm Φ |
10 cm Φ |
14 cm Φ |
20 cm Φ |
30 cm Φ |
|
离子束 |
聚焦, 平行, 散射 |
|
|||
|
流量 |
3-10 sccm |
5-30 sccm |
5-30 sccm |
10-40 sccm |
15-50 sccm |
|
通气 |
Ar, Kr, Xe, O2, N2, H2, 其他 |
||||
|
典型压力 |
< 0.5m Torr |
< 0.5m Torr |
< 0.5m Torr |
< 0.5m Torr |
< 0.5m Torr |
|
长度 |
12.7 cm |
23.5 cm |
24.6 cm |
30 cm |
39 cm |
|
直径 |
13.5 cm |
19.1 cm |
24.6 cm |
41 cm |
59 cm |
|
中和器 |
LFN 2000 |
||||
射频离子源 RFICP 系列应用:
离子辅助镀膜 IBAD ( Ion beam assisted deposition in thermal & e-beam evaporation )
离子清洗 PC (In-situ preclean in sputtering & evaporation )
表面改性, 激活 SM (Surface modification and activation )
离子蚀刻 IBE (Ion beam etching of surface features in any material)
离子溅镀 IBSD (Ion beam sputter deposition of single and multilayer structures)

|
上海伯东离子源典型应用: 安装在离子蚀刻机中的 KRI 射频离子源, 对应用于半导体后端的6寸晶圆进行刻蚀. 右图: 射频离子源 RFICP 安装于腔内 |
1978 年 Dr. Kaufman 博士在美国创立 Kaufman & Robinson, Inc 公司, 研发生产考夫曼离子源, 霍尔离子源和射频离子源. 美国考夫曼离子源历经 40 年改良及发展已取得多项专利. 离子源广泛用于离子清洗 PC, 离子蚀刻 IBE, 辅助镀膜 IBAD, 离子溅射镀膜 IBSD 领域, 上海伯东是美国考夫曼离子源中国总代理.
若您需要进一步的了解详细信息或讨论, 请参考以下联络方式:
上海伯东: 罗先生 台湾伯东: 王女士
T: +86-21-5046-1322 T: +886-3-567-9508 ext 161
F: +86-21-5046-1490 F: +886-3-567-0049
M: +86 152-0195-1076 M: +886-939-653-958
www.hakuto-china.cn www.hakuto-vacuum.com.tw
伯东版权所有, 翻拷必究!











